5年
13611616628
微信在線
關(guān)鍵詞 |
無壓納米燒結(jié)銀膏,無壓燒結(jié)銀膏,納米燒結(jié)銀膏,無壓燒結(jié)銀 |
面向地區(qū) |
粘合材料類型 |
金屬類 |
燒結(jié)銀AS9376的致密化率? >95%(常壓燒結(jié)) 減少孔隙率(<2%)提升可靠性
?附著力? ≥45 MPa(劃格法) 抗機(jī)械應(yīng)力(滿足芯片堆疊需求)
無壓燒結(jié)銀AS9376用于陶瓷基板互連
?技術(shù)挑戰(zhàn):
在AlN/SiC等高導(dǎo)熱陶瓷基板上實(shí)現(xiàn)高密度布線,需材料CTE與基板匹配。
?AS9376解決方案:
?CTE可調(diào)性:通過玻璃粉組分優(yōu)化(Bi?O?-ZnO-B?O?體系),CTE控制在6 ppm/℃(接近AlN的2.5 ppm/℃)。
?高可靠性:85℃熱沖擊下界面剪切強(qiáng)度>25 MPa,無開裂。
假設(shè)?案例:用于Xilinx UltraScale+ FPGA陶瓷基板,信號(hào)延遲降低10%。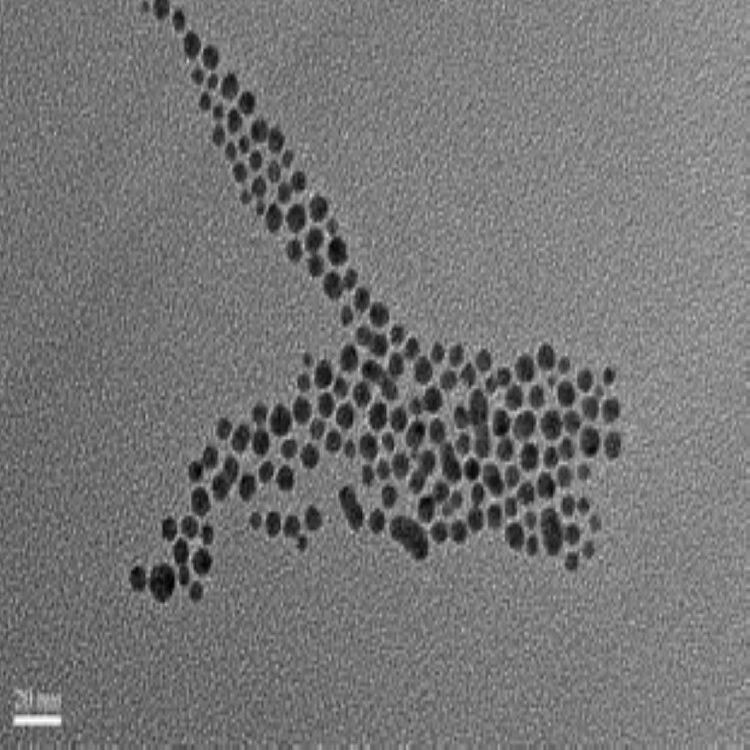
燒結(jié)銀AS9376的未來擴(kuò)展方向
?異質(zhì)集成:
結(jié)合ALD銀膜(厚度~0.3 nm)構(gòu)建三維互連網(wǎng)絡(luò),實(shí)現(xiàn)低電阻(<10?? Ω·cm2)。
?智能化材料:
引入形狀記憶聚合物(SMP)改性銀漿,實(shí)現(xiàn)微裂紋自修復(fù)(修復(fù)效率>90%)。
 江蘇燒結(jié)銀低溫納米燒結(jié)銀kyocer
江蘇燒結(jié)銀低溫納米燒結(jié)銀kyocer
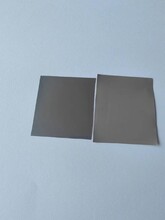 日本燒結(jié)銀替換光纖激光器燒結(jié)銀
日本燒結(jié)銀替換光纖激光器燒結(jié)銀
 燒結(jié)銀膠光纖激光器燒結(jié)銀Alpha
燒結(jié)銀膠光纖激光器燒結(jié)銀Alpha
 燒結(jié)銀膠150度燒結(jié)銀德國(guó)燒結(jié)銀
燒結(jié)銀膠150度燒結(jié)銀德國(guó)燒結(jié)銀
 納米燒結(jié)銀膠江蘇燒結(jié)銀Alpha納
納米燒結(jié)銀膠江蘇燒結(jié)銀Alpha納
 快速固化導(dǎo)電膠光伏組件導(dǎo)電膠
快速固化導(dǎo)電膠光伏組件導(dǎo)電膠
 異質(zhì)結(jié)導(dǎo)電膠上海導(dǎo)電膠導(dǎo)電銀膠
異質(zhì)結(jié)導(dǎo)電膠上海導(dǎo)電膠導(dǎo)電銀膠
 日本燒結(jié)銀替代低溫?zé)o壓燒結(jié)銀大
日本燒結(jié)銀替代低溫?zé)o壓燒結(jié)銀大
 燒結(jié)銀膠環(huán)保燒結(jié)銀國(guó)產(chǎn)燒結(jié)銀
燒結(jié)銀膠環(huán)保燒結(jié)銀國(guó)產(chǎn)燒結(jié)銀
 加壓燒結(jié)銀日本燒結(jié)銀替換
加壓燒結(jié)銀日本燒結(jié)銀替換

————— 認(rèn)證資質(zhì) —————
廣州本地?zé)Y(jié)銀AS9376高導(dǎo)熱銀膏熱銷信息